Kunststoffe wie Hochleistungs-PPS und Hochleistungspolyester (MID) werden auch metalliert.
Gerne helfen wir Ihnen bei der Entwicklung Ihres Substrat oder MID (Molded Interconnct Devices).
Wichtigste Vorteile
- KEINE Luftblasen unter der Kupferfläche
- Unterschiedlich dicke Metallisierung auf einem Substrate, z.B. 10 um bis 300 um
- Substrat mit Steckerfunktion
- Endmetallisierung nach Wunsch bzw. Applikation
- Sehr gute Löteigenschaften, auch für Hochtemperaturlöten
- Sehr gute Bondeigenschaften, Dünndraht wie Dickdraht
- Extrem feine Auflösung < 50 um Line / Space
- Höhere Schaltungsdichte als auf herkömmliches FR4, FR2, PTFE, Polyimide Materialen und in der Dickfilm Technologie
- Sehr gute Hochfrequenz Charakteristik
- Gutes Temperatur Management und Wärmeableitungs-Vermögen
- Hervorragende Lötbarkeit und Wirebond Charakteristik
- Niedrige Werkzeugkosten und schnelles amortisieren der Prototypen
- Vielseitigkeit
- Besseres Preis-Leistungsverhältnis wie herkömmliche Dünnschichtsubstrate
- Die Substrate sind sehr robust
Die Fertigung eines CPC Substrates wird wie folgt realisiert:
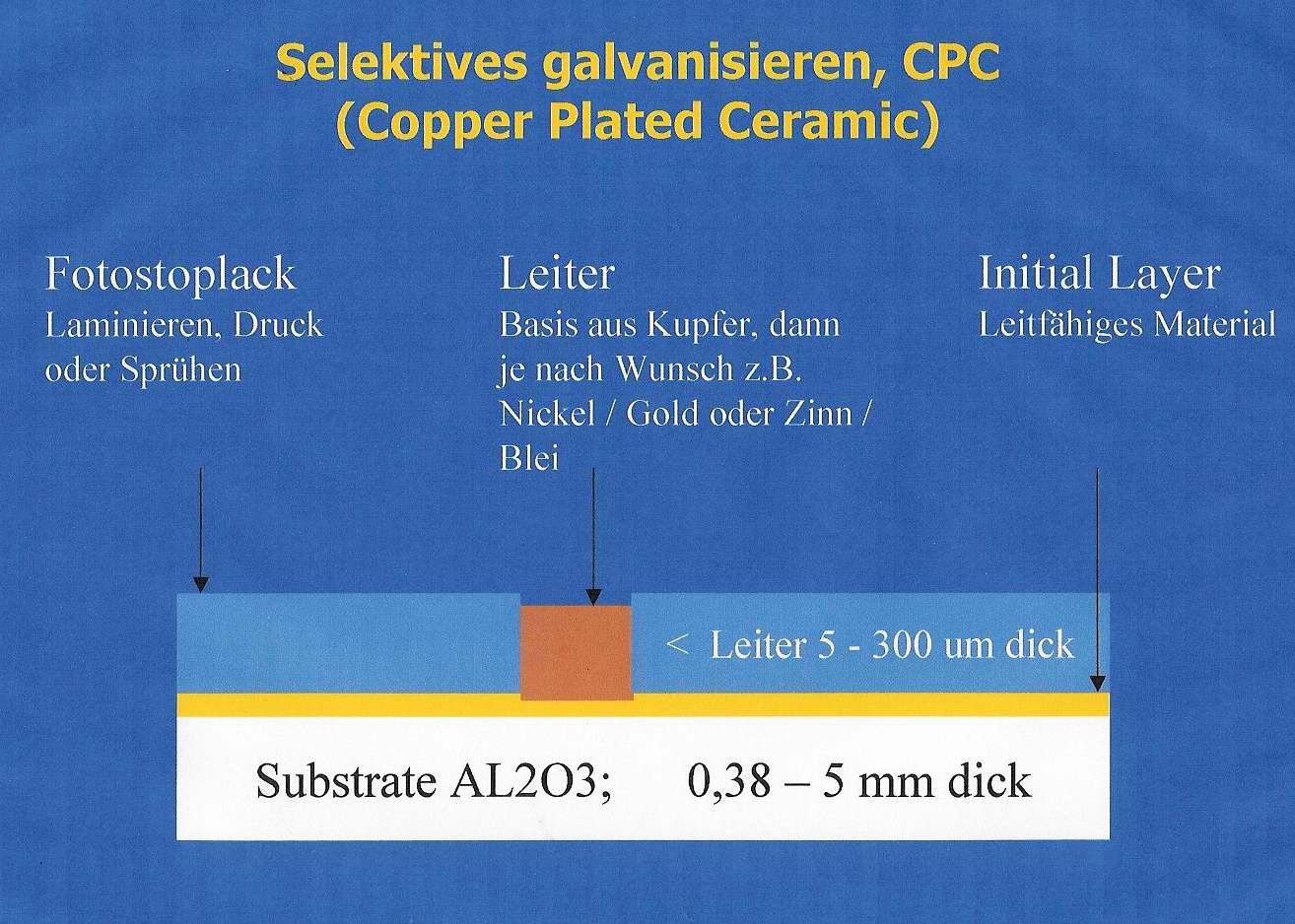
- Metallisierung des Keramik Substrats durch aufbringen einer dünnen leitenden Schicht
- Aufbringen des Photoresists
- Belichten mit UV Licht, ätzen
- Galvanisch metallisieren
- Entfernen des Fotostopplackes und dem Initiallayer. Es bleiben nur noch die Leiter auf dem Substrate haften
- Mit diesem Verfahren sind Leiterbahnabstände <30 um möglich
Die CPC Substarte kommen dort zum Einsatz
wo Dickschicht- und Dünnschicht Hybride verwendet werden oder FR4
Leiterplatten an Ihre Grenzen stoßen. Der einfache und reproduzierbare CPC
Prozess kann häufig Dünnschicht- und Dickschicht-Schaltungen preisgünstig
ersetzen.
Die sehr gute Hochfrequenz Charakteristik ist optimal für Anwendungen bis 40
GHz. Das gute Temperatur Management und Wärmeableitungs-Vermögen wird
kombiniert mit einer hervorragende Lötbarkeit und wire bonding
Charakteristik. Je nach Bondprozess wird die entsprechende Metallisierung
vorgenommen z.B. Kupfer, Nickel und Gold. Diese positiven Eigenschaften
machen CPC Substrate für Power Module und andere Anwendungen sehr
interessant.
3-Dimensionale CPC Substrate finden Einzug in der Fiberoptic Industrie. Hier
gibt es einige spezifische Anwendungen wo das Bonden des Optischen Sensors
und das wire bonding auf einer der Seiten des Substrates durchgeführt wird.
Dieser Prozess bringt eine erhebliche Vereinfachung bei der Umsetzung von
optischen in elektrische Signale.
Gerne helfen wir Ihnen weiter bei der Einführung neuer Techniken. Das
betrifft die Entwicklungsdienstleistung für Power- und HF Anwendungen ebenso
wie das schnelle und preisgünstige fertigen von Mustersubstraten..